シードエッチング
次世代半導体は、高性能化や高速化のため微細化が進められています。それに伴い、再配線層、バンプ、インターポーザや半導体パッケージ基板の微細化が求められています。当社のセミアディテイブ用銅シードエッチング液は有機酸/過酸化水素系薬液、セミアディテイブ用チタンシードエッチング液はアルカリ/過酸化水素系薬液で、ともに微細配線や微細バンプ形成に対応しています。
SAP用Cuシードエッチング液:アデカケルミカ CSEシリーズ
想定用途
FC-BGA、FO-WLP/PLP、2.xD/3Dパッケージ(チップレット等)
RDL
特長
- 微細配線対応 L/S=1.5μm/1.5μm
- Cu表面平滑性維持により伝送損失を最小限に抑制
- Cu表面の変色を抑制
- アンダーカットなし

TEG spec : L/S=1.5μm/1.5μm
Electrolytic Cu : 3.5μm thickness
Sputter Cu : 0.15μm thickness
Sputter Ti : 0.05μm thickness
Electrolytic Cu E.R. : 3.9nm/sec.
Sputter Cu E.R. : 4.3nm/sec.
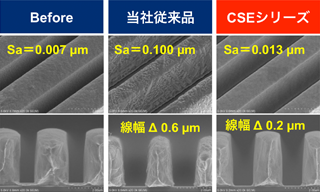
Bump
特長
- 微細Bump対応 Pitch=10μm(Φ=5μm)
- SnAg(錫銀)、Ni(ニッケル)を腐食しない
- ガルバニック腐食なし

Test spec : Bump Φ = 20μm
SnAg solder : 20μm thickness
Ni platting : 3μm thickness
Electrolytic Cu : 40μm thickness
Sputter Cu : 0.5μm thickness
Sputter Ti : 0.1μm thickness
Electrolytic Cu E.R. : 3.9nm/sec.
Sputter Cu E.R. : 4.3nm/sec.

SAP用Tiシードエッチング液:アデカテック WTI/Wシリーズ
想定用途
FC-BGA、FO-WLP/PLP、2.xD/3Dパッケージ(チップレット等)
特長
- アンダーカットが小さく、微細配線にも対応 L/S = 1.5μm/1.5μm
- Cu(銅)、Ni(ニッケル)、SnAg(錫銀)を腐食しない
- フッ化物非含有

TEG spec : L/S=1.5μm/1.5μm
Electrolytic Cu : 3.5μm thickness
Sputter Cu : 0.15μm thickness
Sputter Ti : 0.05μm thickness
Sputter Ti E.R. : 1.0nm/sec.