Seed etchant for semi-additive process
As next-generation semiconductors are being miniaturized to achieve higher performance and speed, miniaturization of redistribution layers, bumps, interposers and semiconductor package substrates is required. Our semi-additive copper seed etchant is an organic acid/hydrogen peroxide-based solution, and our semi-additive titanium seed etchant is an alkali/hydrogen peroxide-based solution compatible with fine wiring and fine bump formation.
Cu seed etchant for semi-additive process:ADEKA CHELUMICA CSE series
Applications
FC-BGA, FO-WLP/PLP, 2.xD/3D package(Chiplet, etc.)
RDL
Features
- Conform to the narrow space 【L/S=1.5μm/1.5μm】
- Minimize transmission loss by smoothing a copper surface
- Suppresses discoloration of Cu surface
- No Cu under cut

TEG spec : L/S=1.5μm/1.5μm
Electrolytic Cu : 3.5μm thickness
Sputter Cu : 0.15μm thickness
Sputter Ti : 0.05μm thickness
Electrolytic Cu E.R. : 3.9nm/sec.
Sputter Cu E.R. : 4.3nm/sec.
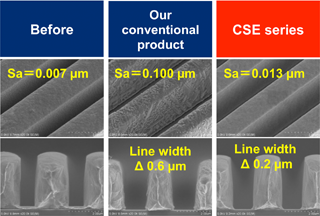
Bump
Features
- Conform to the fine bump pitch 【Pitch=10μm(Φ=5μm)】
- No corrosion to SnAg and Ni
- No galvanic corrosion

Test spec : Bump Φ = 20μm
SnAg solder : 20μm thickness
Ni platting : 3μm thickness
Electrolytic Cu : 40μm thickness
Sputter Cu : 0.5μm thickness
Sputter Ti : 0.1μm thickness
Electrolytic Cu E.R. : 3.9nm/sec.
Sputter Cu E.R. : 4.3nm/sec.

Ti seed etchant for semi-additive process:ADEKA TEC WTI/W series
Applications
FC-BGA, FO-WLP/PLP, 2.xD/3D package(Chiplet, etc.)
Features
- Small under cut, conform to the narrow space 【L/S=1.5μm/1.5μm】
- No corrosion to SnAg, Ni and Cu
- No fluorine

TEG spec : L/S=1.5μm/1.5μm
Electrolytic Cu : 3.5μm thickness
Sputter Cu : 0.15μm thickness
Sputter Ti : 0.05μm thickness
Sputter Ti E.R. : 1.0nm/sec.